Semiconductor
Players
- 반도체 산업 value chain (Source: LS증권)
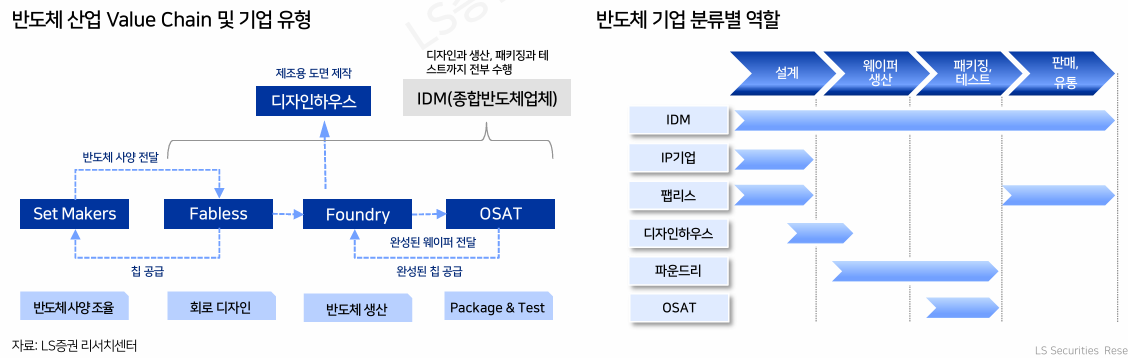
- 메모리/비메모리 반도체 (Source: LS증권)

DRAM
- DRAM은 모바일이랑 서버 수요가 중요하다는 것 확인
- 삼성전자 (005930), SK하이닉스 (000660), Micron Technology (MU) 순
- Legacy에서는 CXMT가 치고 올라오고 있고
- Commodity 시장이었던 곳이 HBM의 등장으로 제품군이 2개로 쪼개짐
- AI향으로 나갈 수 있으나 쌓아 올려서 접합하면서 수율이 박살나는 HBM
- 그 이전에 commodity였던 DRAM
- DRAM demand/market share (Source: LS증권)

NAND
삼성 1위, Kioxia/Western Digital (WDC) 2위, SK하이닉스 3위, Micron 3위
- Kioxia에 SK하이닉스 지분이 있으니… 뭐 대충 2.5등이라고 봐도 괜찮을듯
수요처가 다양한 편이나 여전히 모바일이 주도
Server쪽은 locality 때문에 생각보다 HDD 수요가 있는 편
NAND demand/market share (Source: LS증권)

- Computer science 전공자라면 memory hierarchy 공부할 때 locality 개념을 배움
- temporal locality - 가장 최근에 조회한 데이터를 다시 한 번 조회할 가능성이 높음
- spatial locality - 조회한 아이템과 물리적으로 가까운 위치에 저장된 데이터를 조회할 가능성이 높음
- Bryant and O’Hallaron, Computer Systems: A Programmer’s Perspective, Third Edition

- 대충 이런 사유 때문에 server 쪽에서 quantity로 보면 HDD > SSD이지 않나
- 생각보다 데이터가 쌓이기만 하지, 쓰는 데이터는 꽤나 정해져 있을 것
- 이런 관점에서 오래된 과거 이메일 지워서 greenhouse gas 줄이자는 주장도 나오는 것…
- 이메일은 무한하게 쌓이기만 하는데 정작 읽는건 최근에 온 메일이다보니
- 아무튼 정확한 reasoning은 아니지만, SDD가 HDD를 전면적으로 대체하는 것이 아니고, 생각보다 server 쪽에서 수요가 받쳐주지 않는 원인을 대략적으로 이렇게 이해하고 있음
Memory tech node
어쨌거나 저쨌거나 DRAM은 선단공정화가 정말 빠르게 진행되고 있음
이제 DRAM은 HBM이랑 legacy DRAM을 구분해서 share를 표시하지 않으면 꽤나 왜곡이 있을 예정
심지어 HBM은 후공정 중요도가 높은 제품이라 선단공정 노드만으로 DRAM 시장에서의 경쟁력이라던가 업황을 한 번에 알아보기에는 한계가 있을 것이라는게 내 생각
DRAM/NODE tech node (Source: LS증권)

시스템 반도체
- 영원토록 Intel (INTC), AMD (AMD)의 영역인 CPU 시장
- Mobile AP는 자사 칩 쓰는 애플 빼고는 전부 ARM (ARM) based로 미디어텍이랑 퀄컴이 2황
- 삼성전자는 이번 갤럭시 최신기종 스냅드래곤 채택으로 곧 사라질 예정
- 시스템 반도체 아키텍쳐 다 까뒤집고 제로부터 설계해야 한다는 썰이 있는데 아예 아니땐 굴뚝에서 연기나는 것 아님
- 시스템 반도체 market share (Source: LS증권)

AI chip
- GPU는 NVIDIA (NVDA), AMD인데 CPU랑은 다르게 NVIDIA의 독주
- AI chip은 보면 자체 설계 비중이 조금씩 올라갈 거라고 예상하고 있고
- 이 때문에 ASIC 쪽에서 경쟁력 있는 Broadcom (AVGO), 다른 architecture를 제공하는 ARM이 주목받는 것
- GPU/AI chip market share (Source: LS증권)

비메모리 반도체 생태계
한국만 메모리/비메모리 반도체로 구분
글로벌은 시스템/메모리/아날로그 반도체로 구분
비메모리 semiconductor value chain (Source: LS증권)
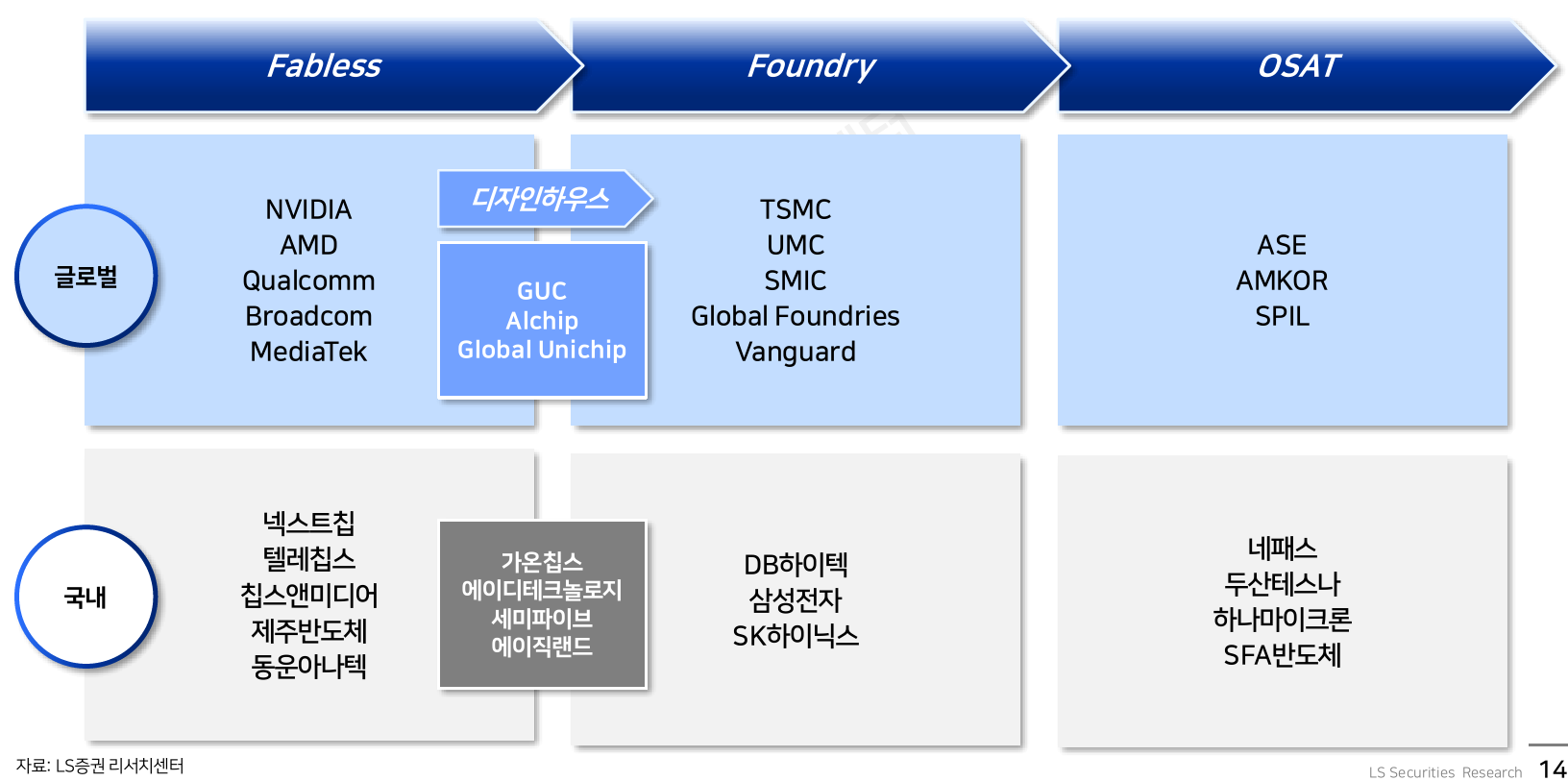
- Semiconductor front-end process (Source: LS증권)

- Semiconductor back-end process (Source: LS증권)
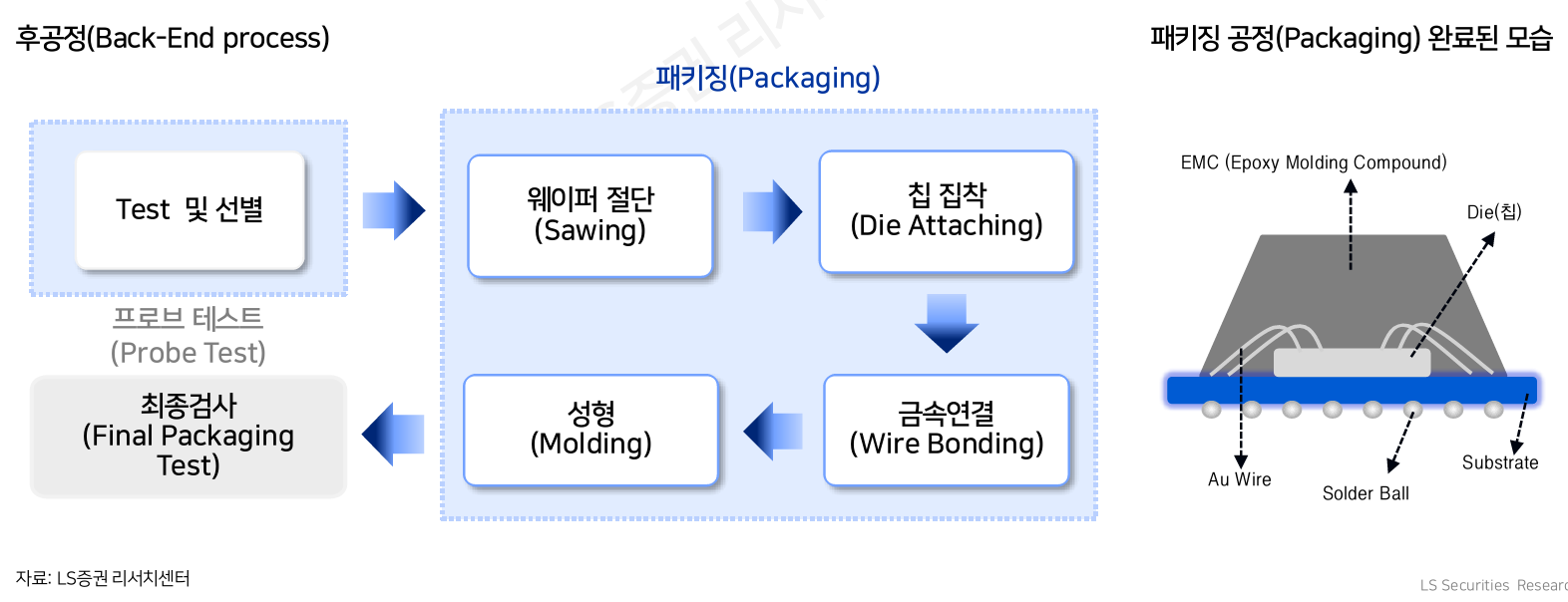
Front-end process
- 반도체 웨이퍼는 일본 2사 (Shin-Etsu Chemical (TSE: 4063), Sumco (TSE: 3436)), 대만의 GlobalWafers (TPEX: 6488)랑 SK실트론이 사실상 과점
- 저거 반도체 잉곳을 만들기 위해 실리콘을 녹이는 도가니가 초고순도 모래로 만들어야 한다는데, 그걸 미국의 광산 단 한곳에서만 채취할 수 있다… 뭐 그런 내용도 봤음
- 이 때문에 중국의 반도체 굴기는 이루어질 수 없는 꿈 같은 것이라는 주장
- 반도체 웨이퍼 제조 및 설계 순서, 웨이퍼 market share (Source: LS증권)
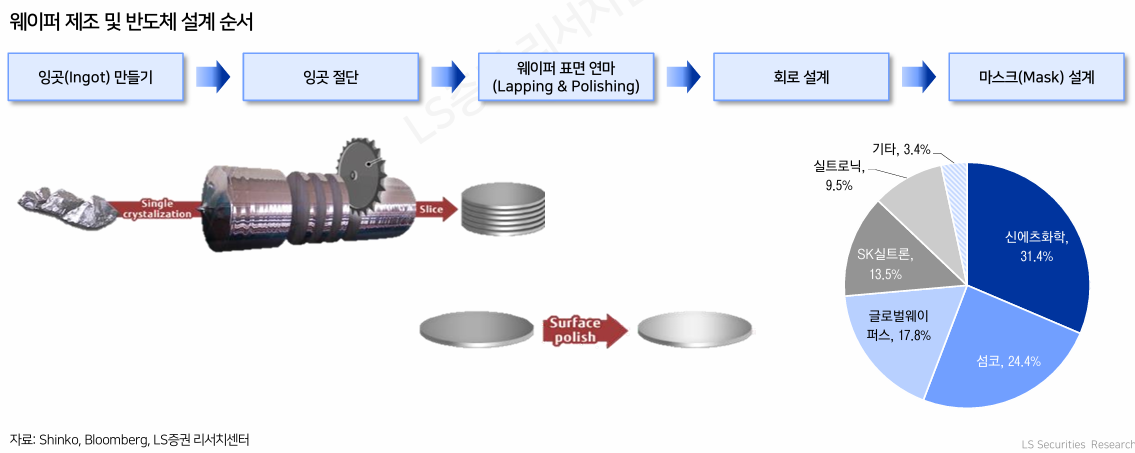
주요기업
Lithography: ASML (ENXTAM: ASML, NASDAQ: ASML)
Development: TEL (TSE: 8035)
Etching: ASM (ENXTAM: ASM), Lam Research (LRCX), Applied Materials (AMAT)
Semiconductor front-end process (Source: LS증권)
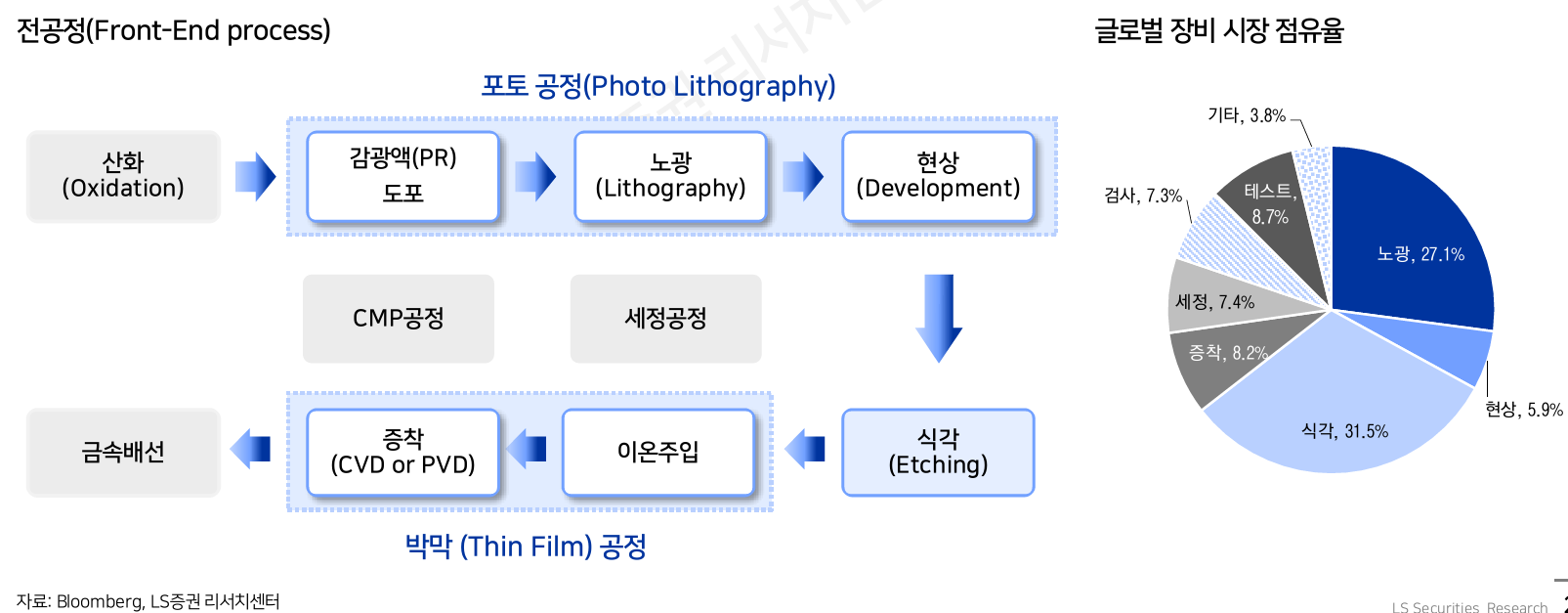
Oxidation layering
- Oxidation layering process (Source: LS증권)
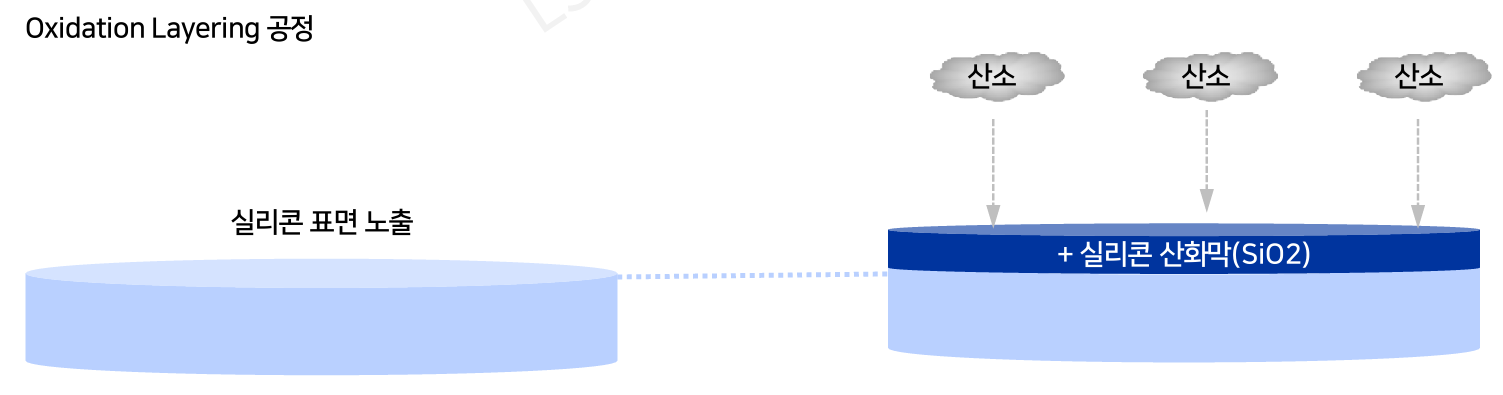
Photo/Photo-resist/Lithography/Development
- Lithography process/market share (Source: LS증권)
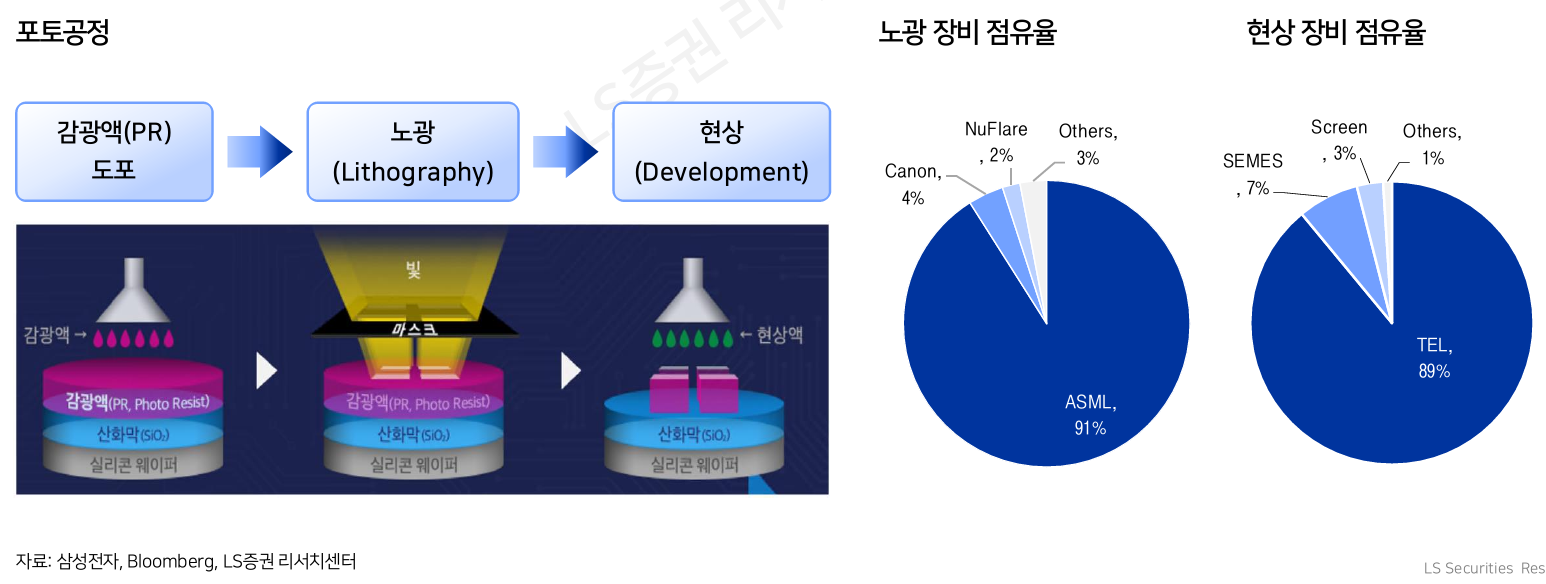
- Lithography (Source: LS증권)

멀티패너팅은 방망이 깎는 노인이라고 생각하면 됨
- 파장이 더 짧은 광원 (ex. EUV)로 한번에 싹 깎을 수 있는걸
- 뭉툭한 칼로 여러번 깎아서 공예하는 것
반도체 공정은 수율 (생산 칩 중에 양품 칩의 비율)이 중요한데 그래서 공정을 반복적으로 거치지 않고 한큐에 쭉 가는게 제일 중요함
멀티패터닝마냥 여러 공정 loop를 돌아야되면 그 과정에서 수율이 떨어지는 문제가 생김
공정마다 수율을 잡아야 하는 과제는 항상 있지만, 아무리 수율이 높은 공정이여도 확률의 곱셈법칙마냥 수율이 떨어짐
- 90% 수율 공정을 10번 거치면 34%까지 떨어짐
- 투자에서 복리의 반대라고 생각하면 됨
이 때문에 선단공정만 막아도 중국의 반도체 굴기는 꽤나 꺾일 수 밖에 없음
반도체에서 반드시 달성해야 하는 규모의 경제를 그냥 원천 봉쇄하는 행위
물론, 미래에 기술적으로 어떤 돌파구를 만들게 될지는 모름
Multi patterning/ArF vs. EUV comparison (Source: LS증권)
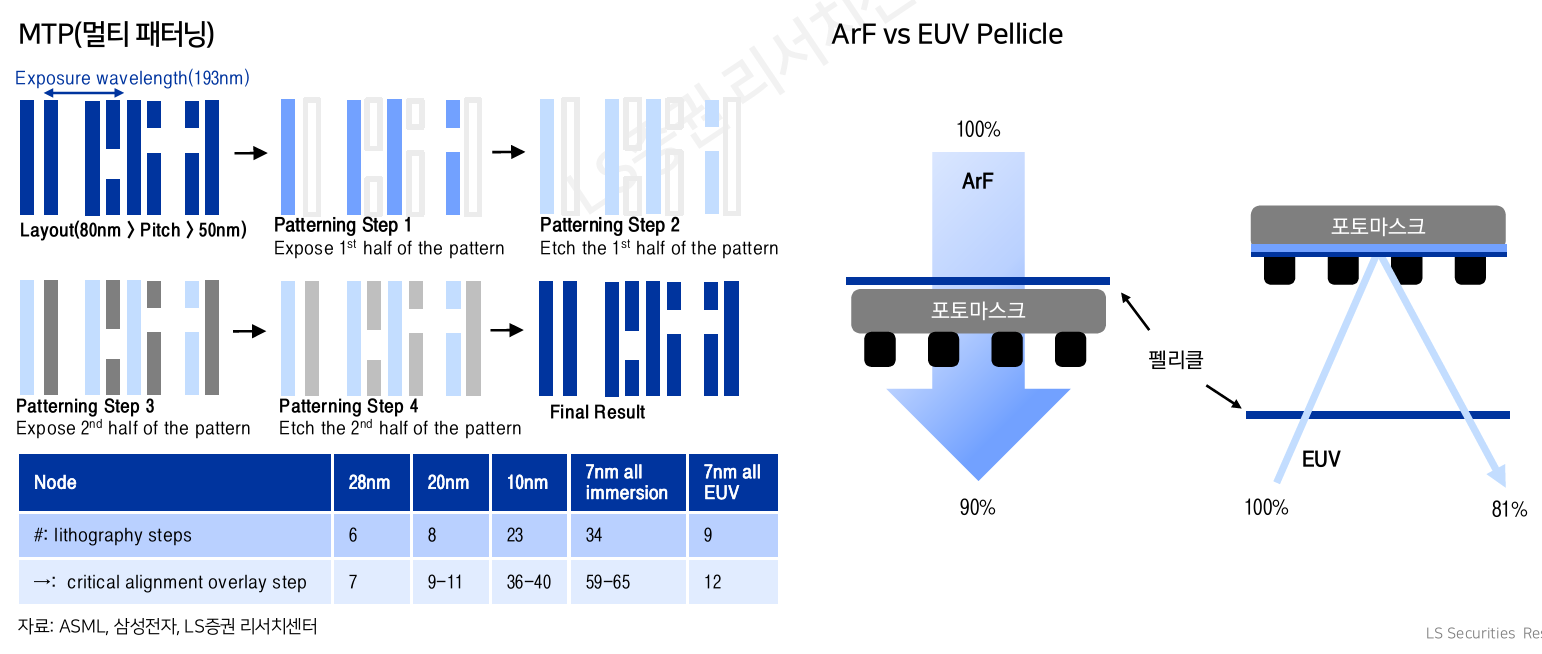
Etching
- Types of etching process (Source: LS증권)
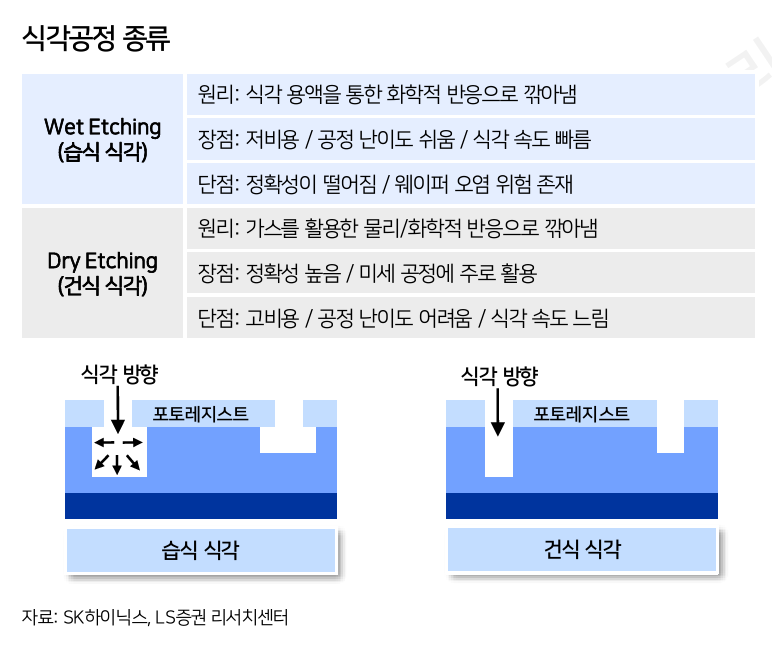
- Etching process/market share (Source: LS증권)

- Etching parts/NAND roadmap (Source: LS증권)

Cleaning
- Cleaning process/market share (Source: LS증권)

Thin film deposition
- Thin film process/CVD/ALD equipment market share (Source: LS증권)

- PVD/CVD/ALD comparison (Source: LS증권)

증착도 HKMG (High-K metal gate) 형태로 진화 중
이 때문에 원자 현미경 (AFM, Atomic Force Microscope)이 필요하다고 들은 것 같음
High-K structure/Atomic Layer epitaxy Deposition (ALD) process (Source: LS증권)
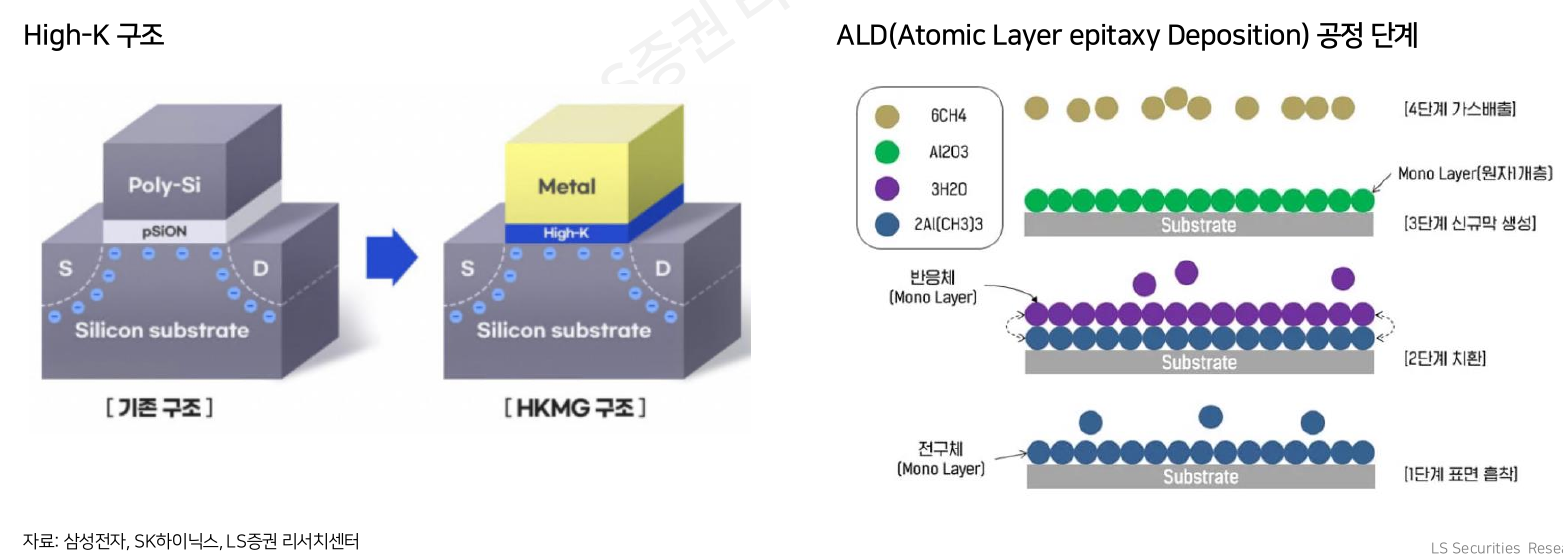
CMP (Chemical Mechanical Polishing)
증착 이후 웨이퍼 포면의 박막을 갈아내는 공정
웨이퍼 표면의 굴곡을 감소시키고 공정 효율 및 수율 개선 기대
HBM 적층 수가 증가하면서 두께가 얇아지고 있어서 CMP 공정 수요가 증가하고 있음
CMP process (Source: LS증권)
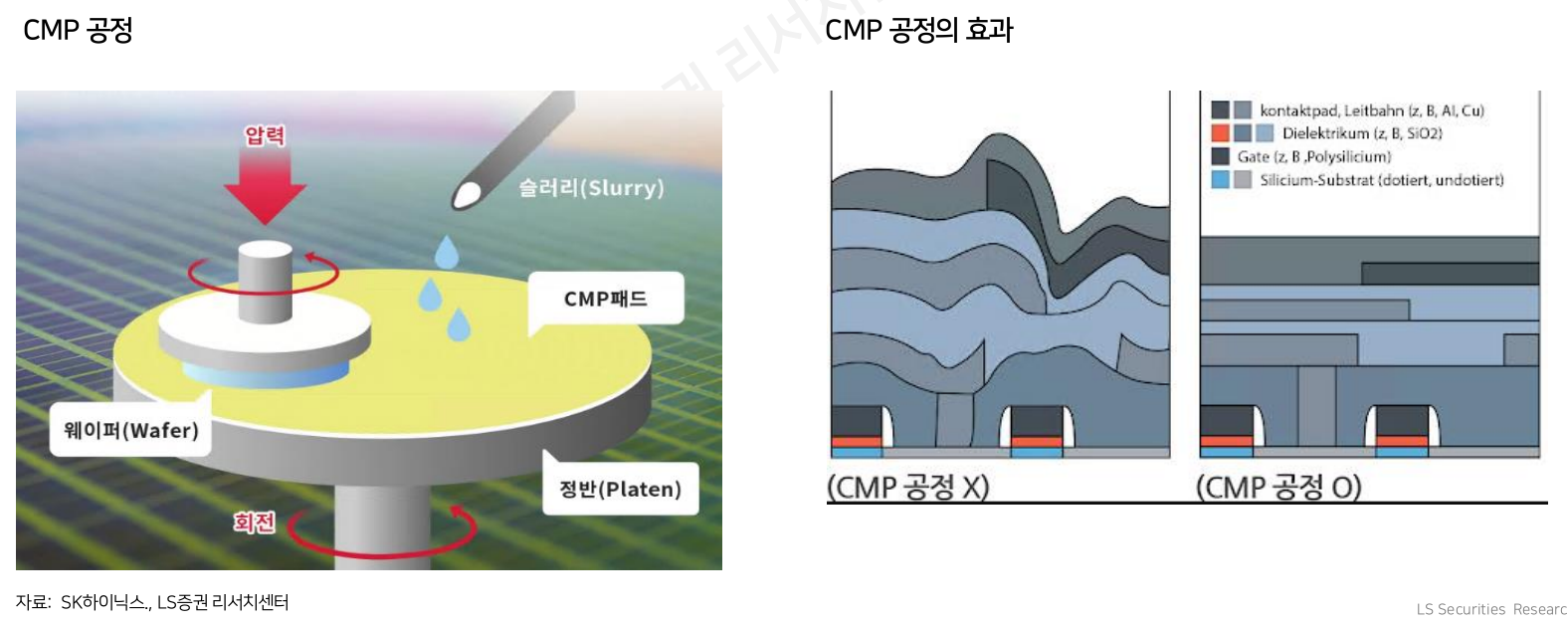
Metal interconnect
열심히 깎고 쌓은 층을 금속 배선으로 연결해야 함
Metal interconnect process (Source: LS증권)
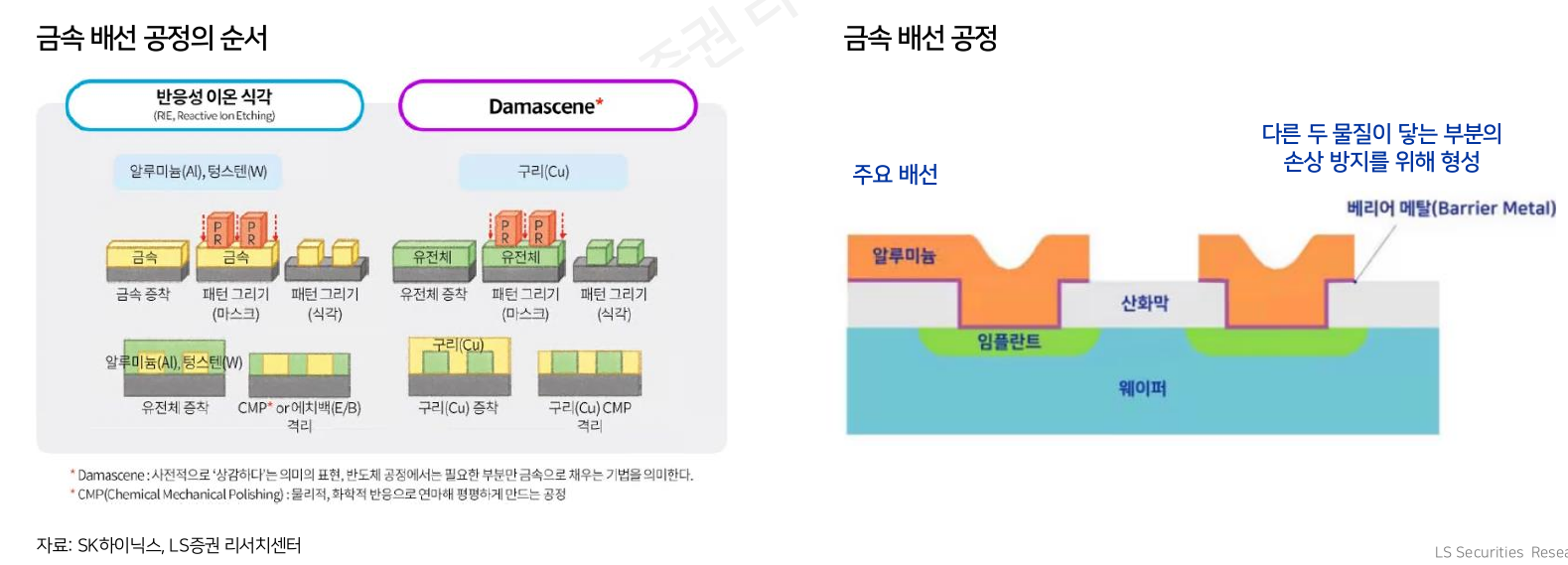
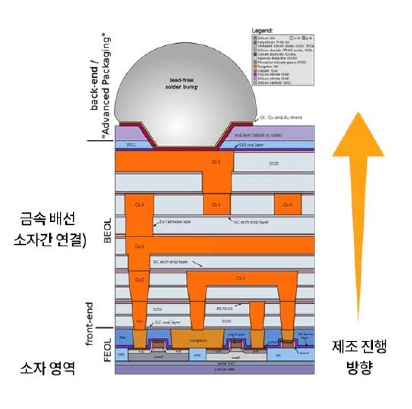
Back-end process
- Back-end process (Source: LS증권)
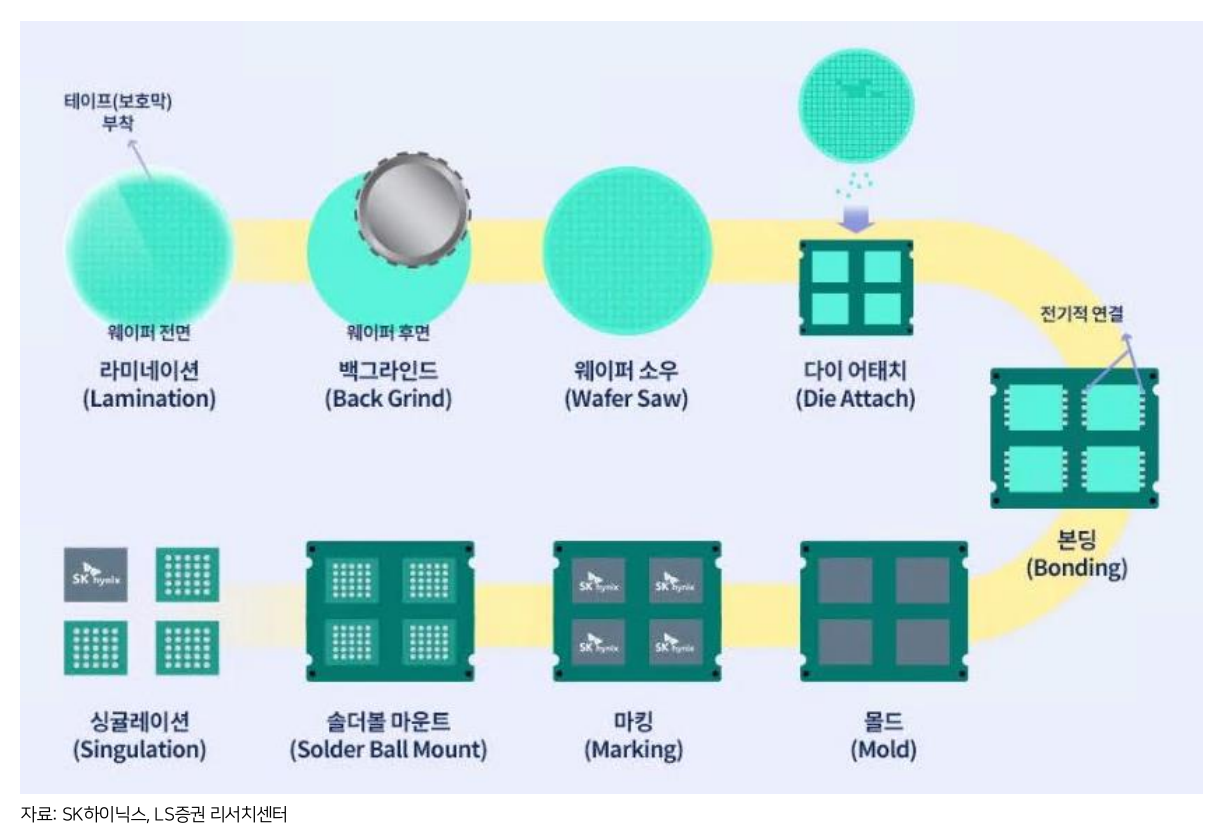

Wafer test
- Wafer test equipment structure/Probe card market share (Source: LS증권)
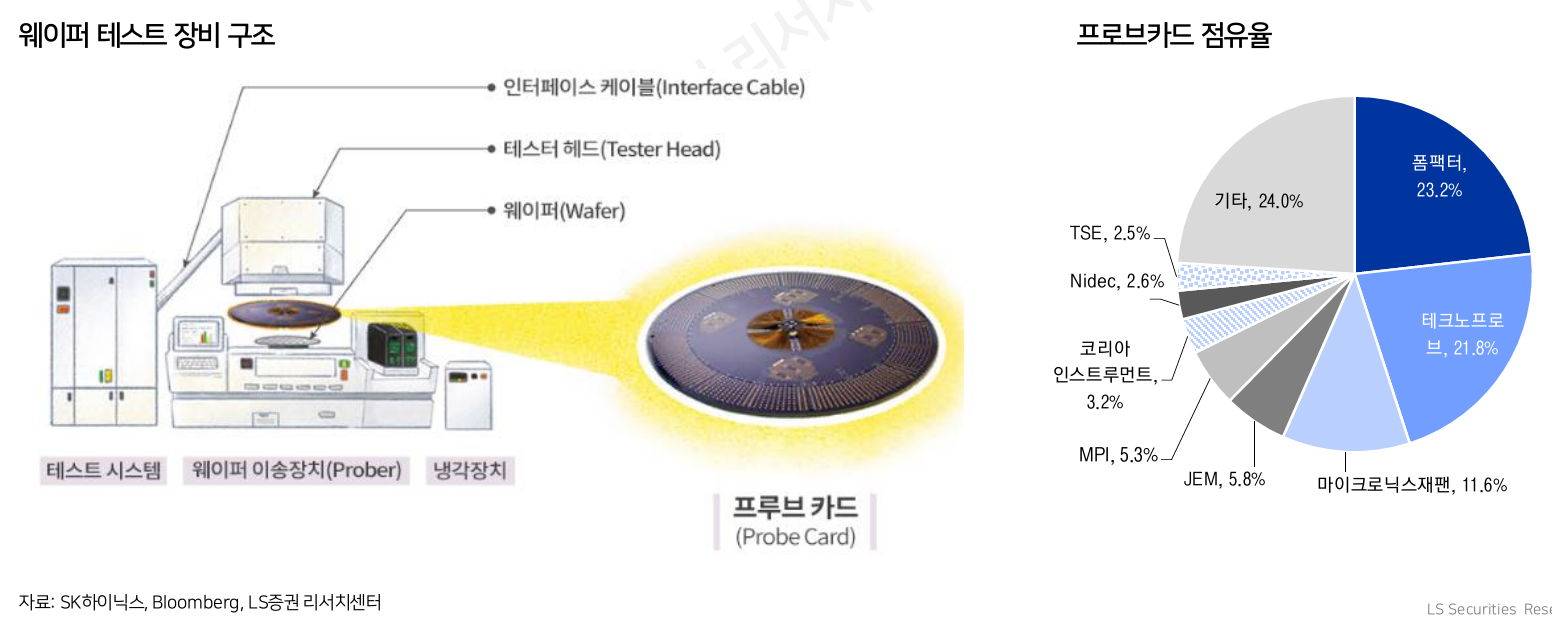
Back grinding
웨이퍼 후면을 갉아내는 공정
웨이퍼 두께를 줄여 적층 수를 증가시킬 수 있다는 장점이 있음
갈아낼 때 깨지거나 휘는 현상이 있음 - warpage
Back grinding (Source: LS증권)
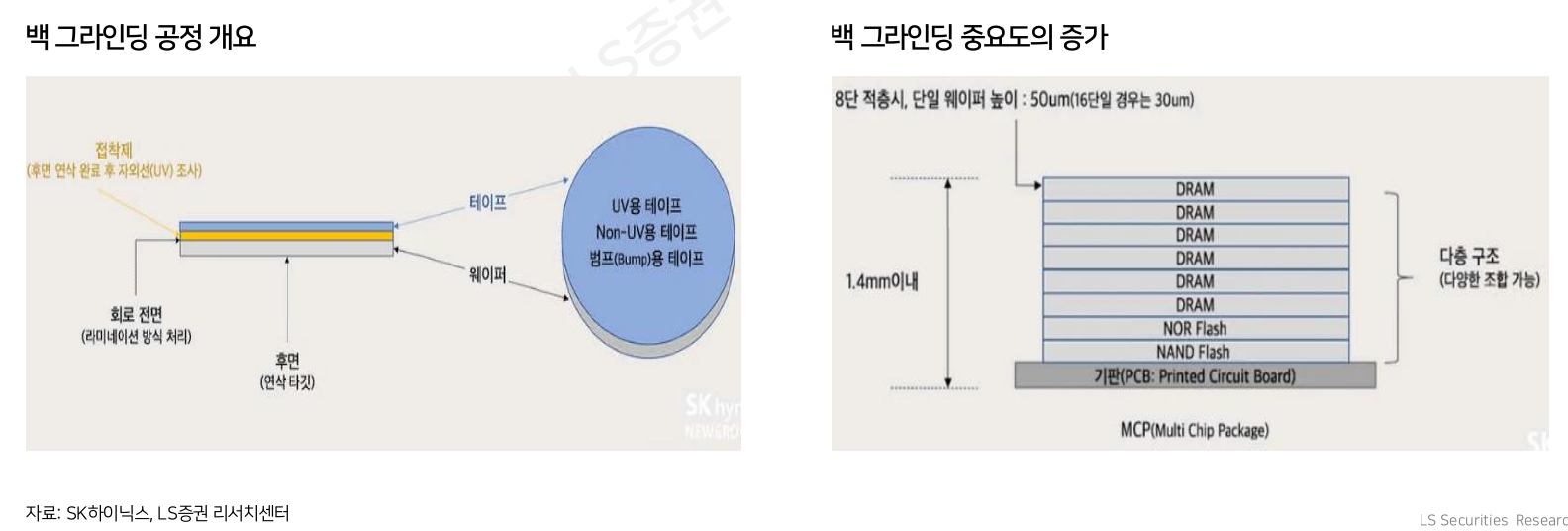
Singulation
웨이퍼 위의 칩을 개별로 나누는 공정 - dicing, sawing
칼로 자르다가 레이저로 자르고 이제는 플라즈마로 자르기 시작
Singulation process/Dicing/Sawing equipment market share (Source: LS증권)

Bonding, molding
- Wire/flip chip bonding/Underfill process (Source: LS증권)
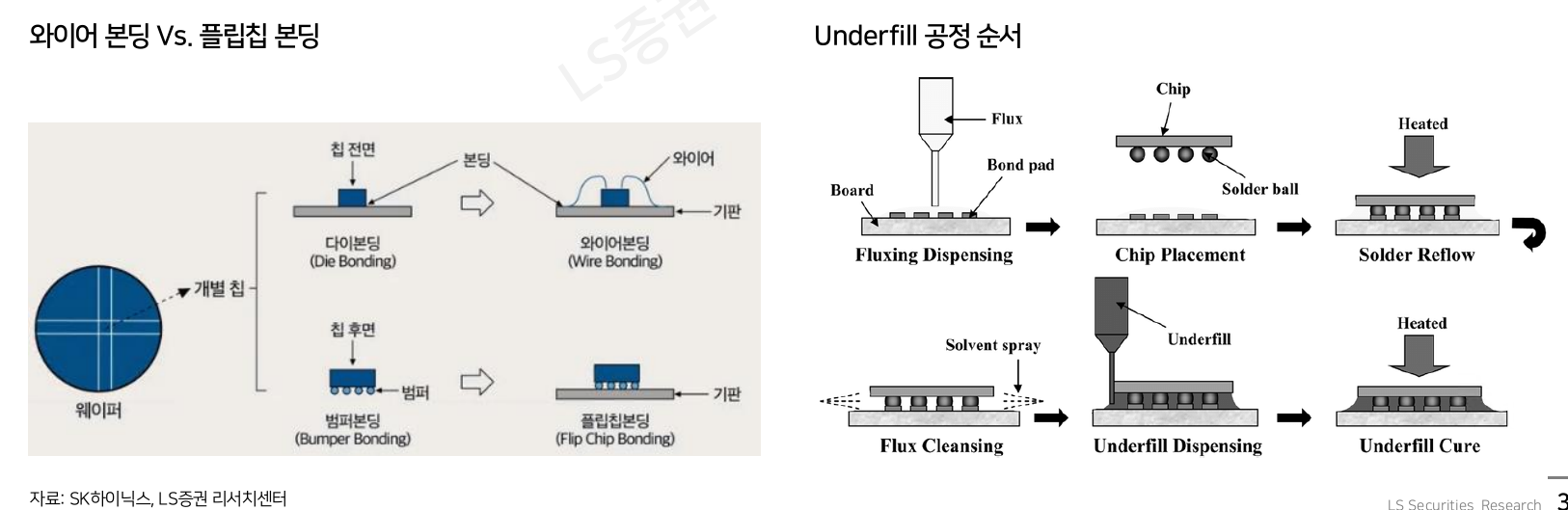
Marking, solderball mount
- Solderball/bump development (Source: LS증권)
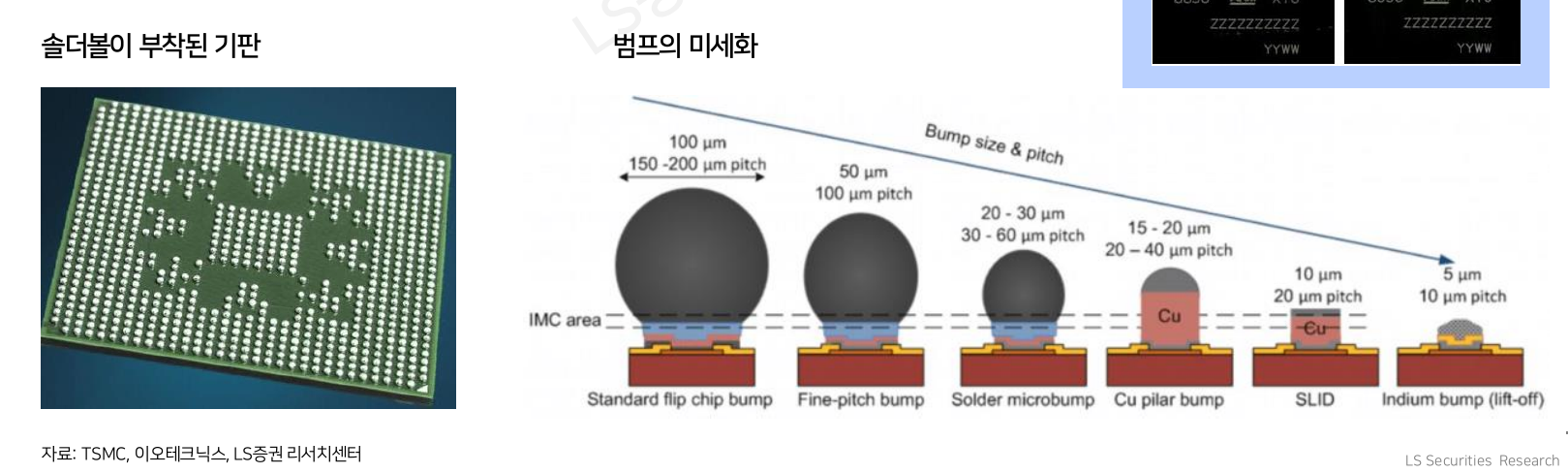
Package test
- Test equipment/socket market share (Source: LS증권)

Inspection, Metrology
- Inspection/mask review equipment market share (Source: LS증권)

Advanced packaging
더이상 노드 미세화로 투자 대비 효용이 안나옴
심지어 양자역학의 세계로 들어가서… 누설 전류 같은 문제가 생김
심지어 성능을 만땅으로 올려두니까 열관리가 안됨
열은 성능이랑 수명에 전반적으로 영향을 미치는데, packaging을 어떻게 하는지가 중요해짐
원래는 다이 하나에다가 다 쑤셔넣는 쪽으로만 연구했는데 웨이퍼 단위로 고민하기 시작
겸사겸사 수율도 올리고 이것저것 시도해보니 결과가 괜찮아짐
AMD Chiplet은 Intel에서도 모방
Node development expense trends/Chiplet technology (Source: LS증권)
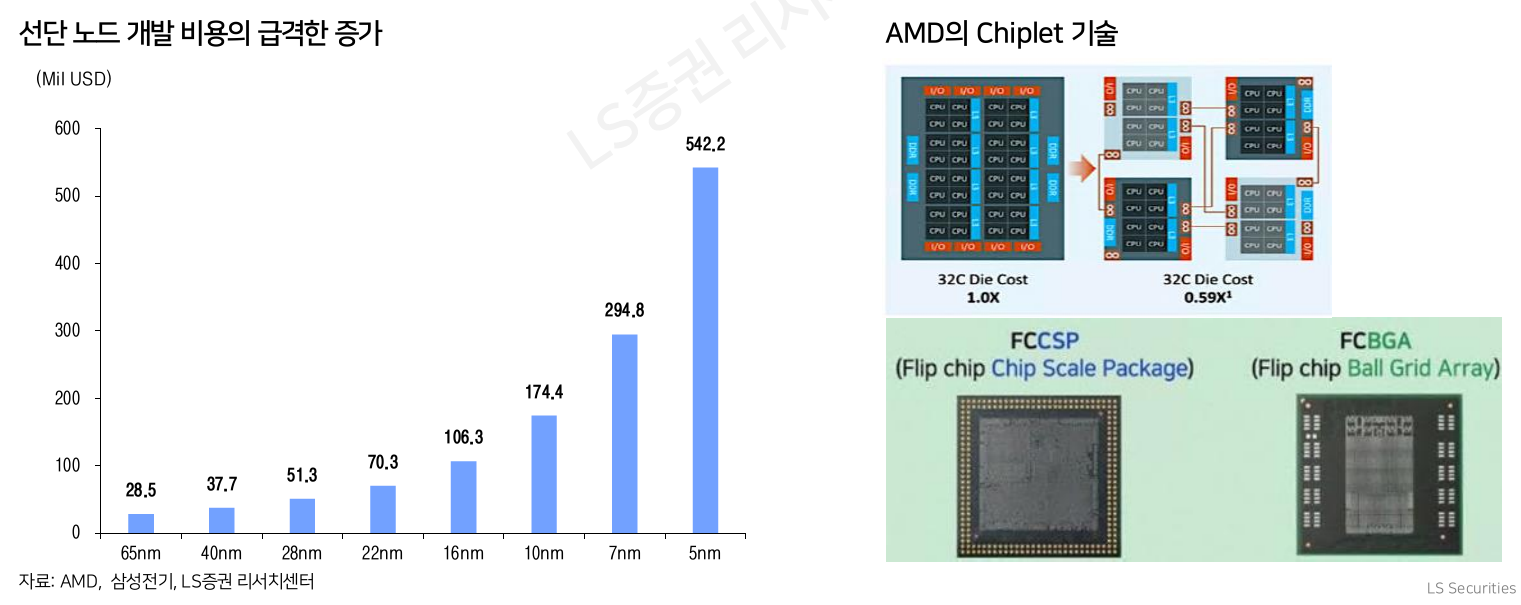
FO-WLP (Fan Out Wafer Level Packaging)
WLP
- 가공이 완료된 웨이퍼 위에 기판을 대신하는 RDL (Re Distribution Layer)이라는 재배선층을 놓은 후 절단하는 방식
- 한 번에 패키징을 진행하는 만큼 생산성과 원가 층면에서 우위가 있음
FO (Fan Out)
- 기존 fan in 구조에서 미세화로 인해 범프를 놓을 공간이 부족해짐
- I/O를 다이 밖으로 빼는 방식으로 전환 - fan out
- FO-WLP 기술로 TSMC (TWSE: 2330, NYSE: TSM)는 2016년부터 아이폰 AP 독점 중
- 이건 물론 삼성전자가 삽질 및 경쟁자로 부상한 영향도 있음…
- WLP/FO-WLP (Source: LS증권)
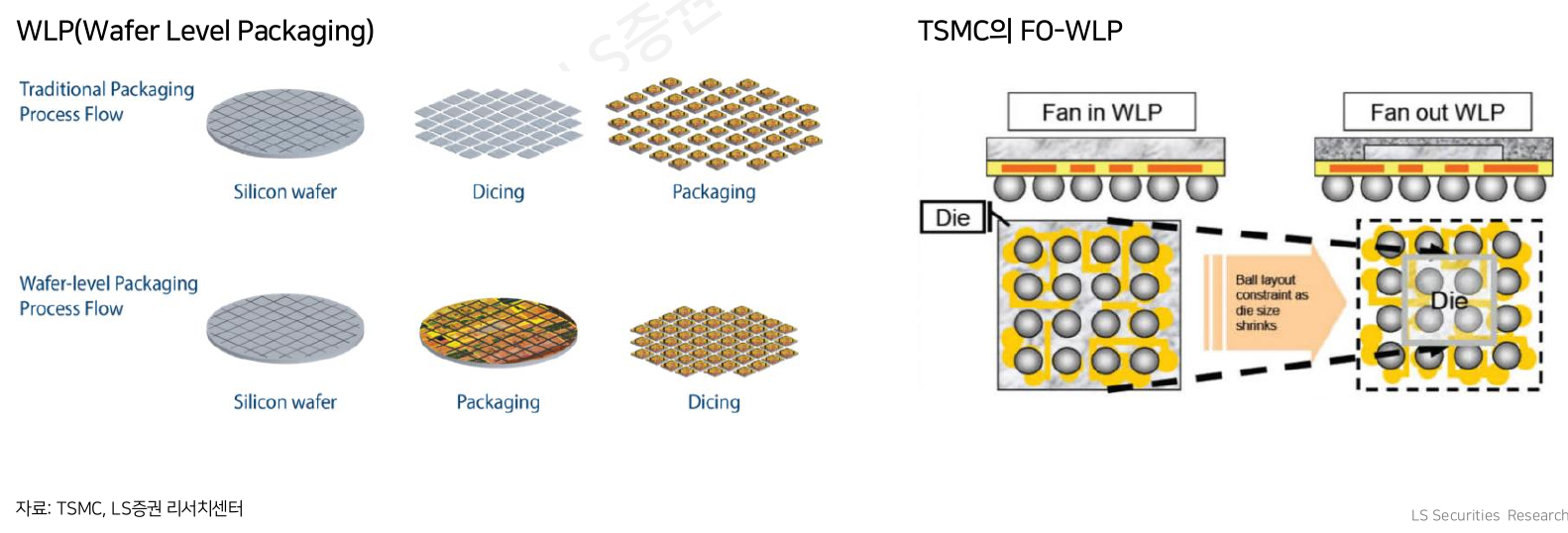
FO-PLP (Fan Out Panel Level Package)
이제 웨이퍼를 벗어나서 panel 단위로 해보려고 하는듯
아직은 초기 중에서도 초기로 보임
FO-PLP technology (Source: LS증권)
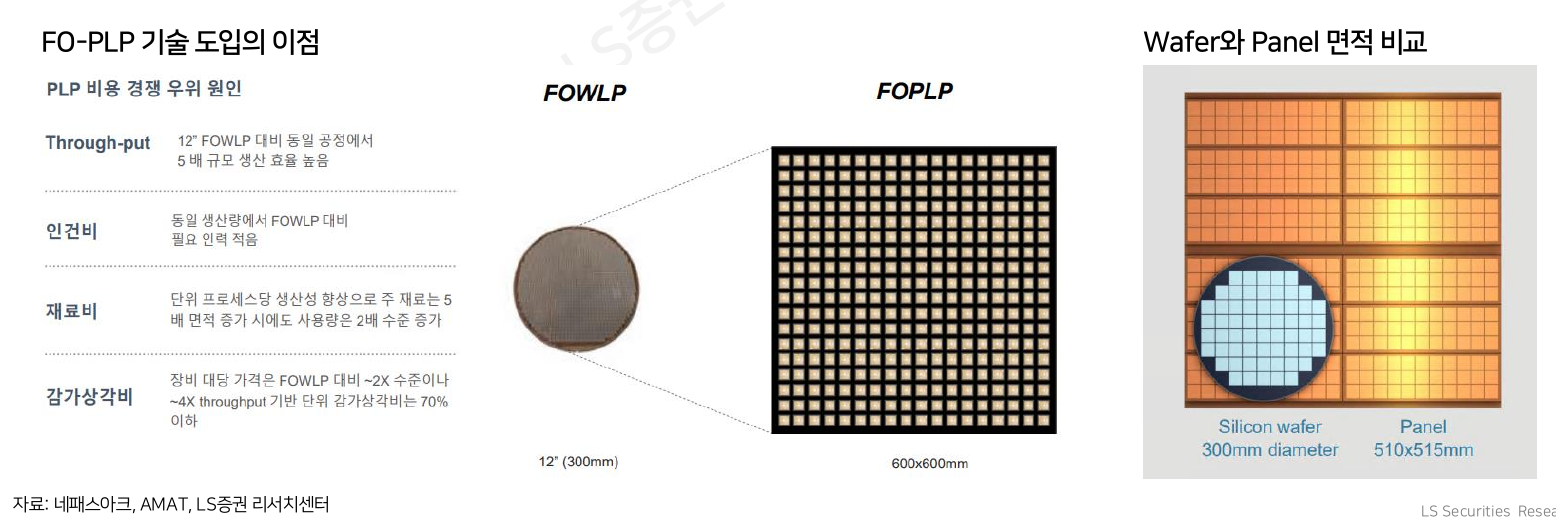
CoWos (Chip on Wafer on Substrate, 2.5D packaging)
서로 다른 칩을 silicon interposer로 연결하는 기술
Silicon interposer가 비싸다고 함
CoWoS/EMIB packaging (Source: LS증권)
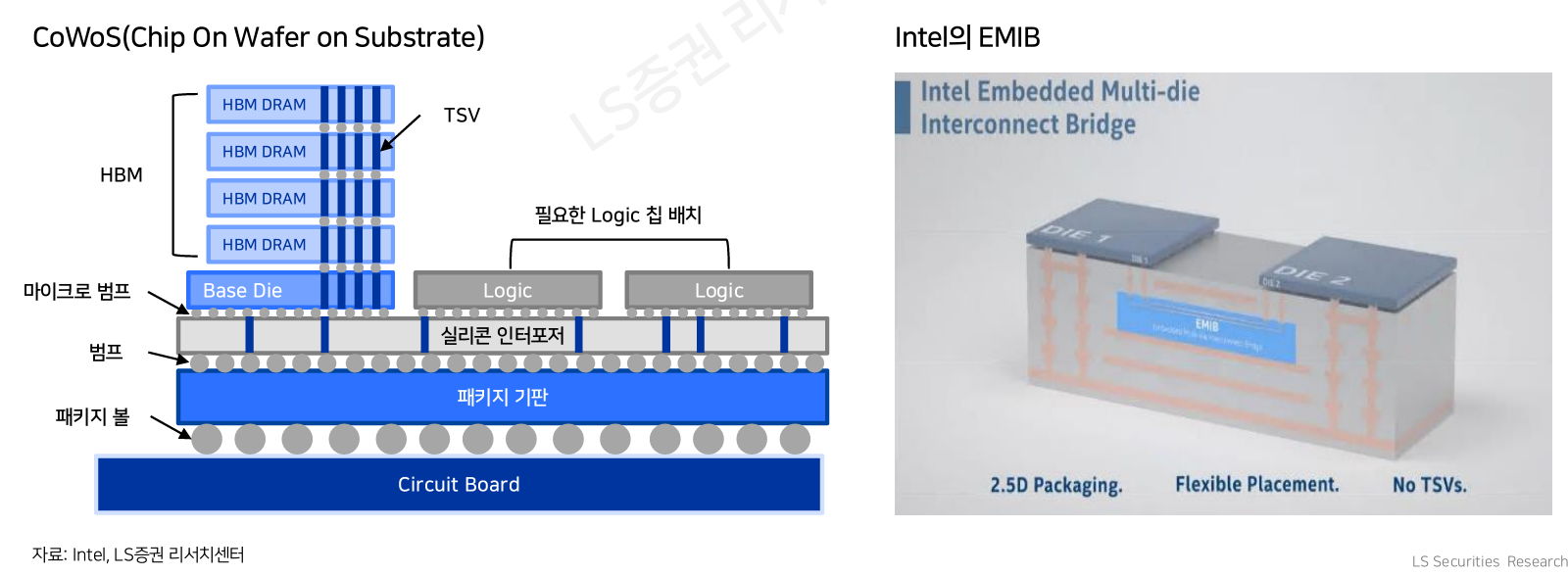
Hybrid bonding (3D packaging)
- 범프를 사용하지 않음
- 수평으로 그냥 연결해버리는 방식
- 비용이나 수율 문제로 시스템 반도체 일부에만 도입되어 있음
- Hybrid bonding 장비 업체
- 네덜란드: BE Semiconductor Industries (ENXTAM: BESI) - 글로벌 독점
- 국내: 한미반도체 (042700), 한화인더스트리얼솔루션즈 (489790) - 개발 중
- 3D packaging (Source: LS증권)

HBM (High Bandwidth Memory)
- HBM market share (Source: LS증권)

- HBM NVIDIA qualification test schedule (Source: LS증권)
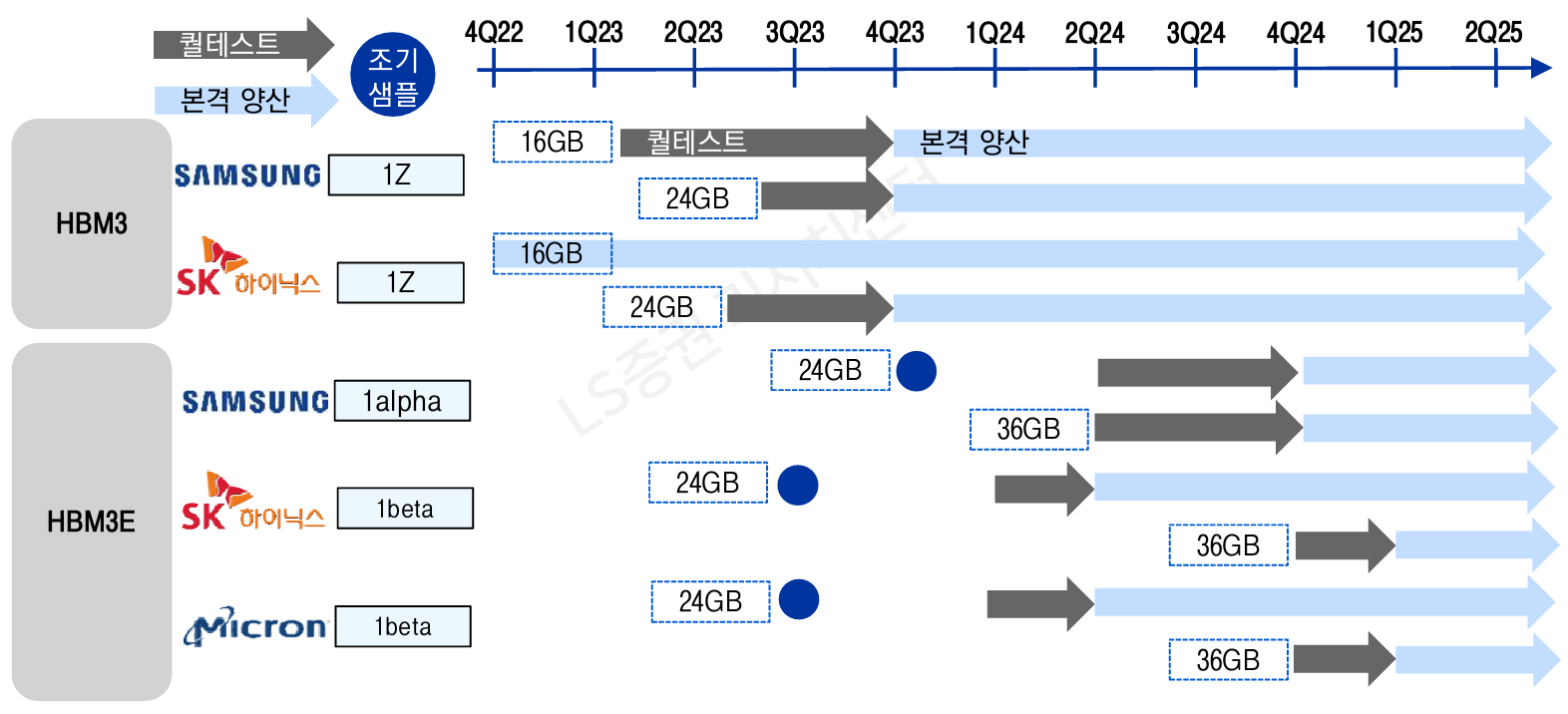
- HBM manufacturing process (Source: LS증권)
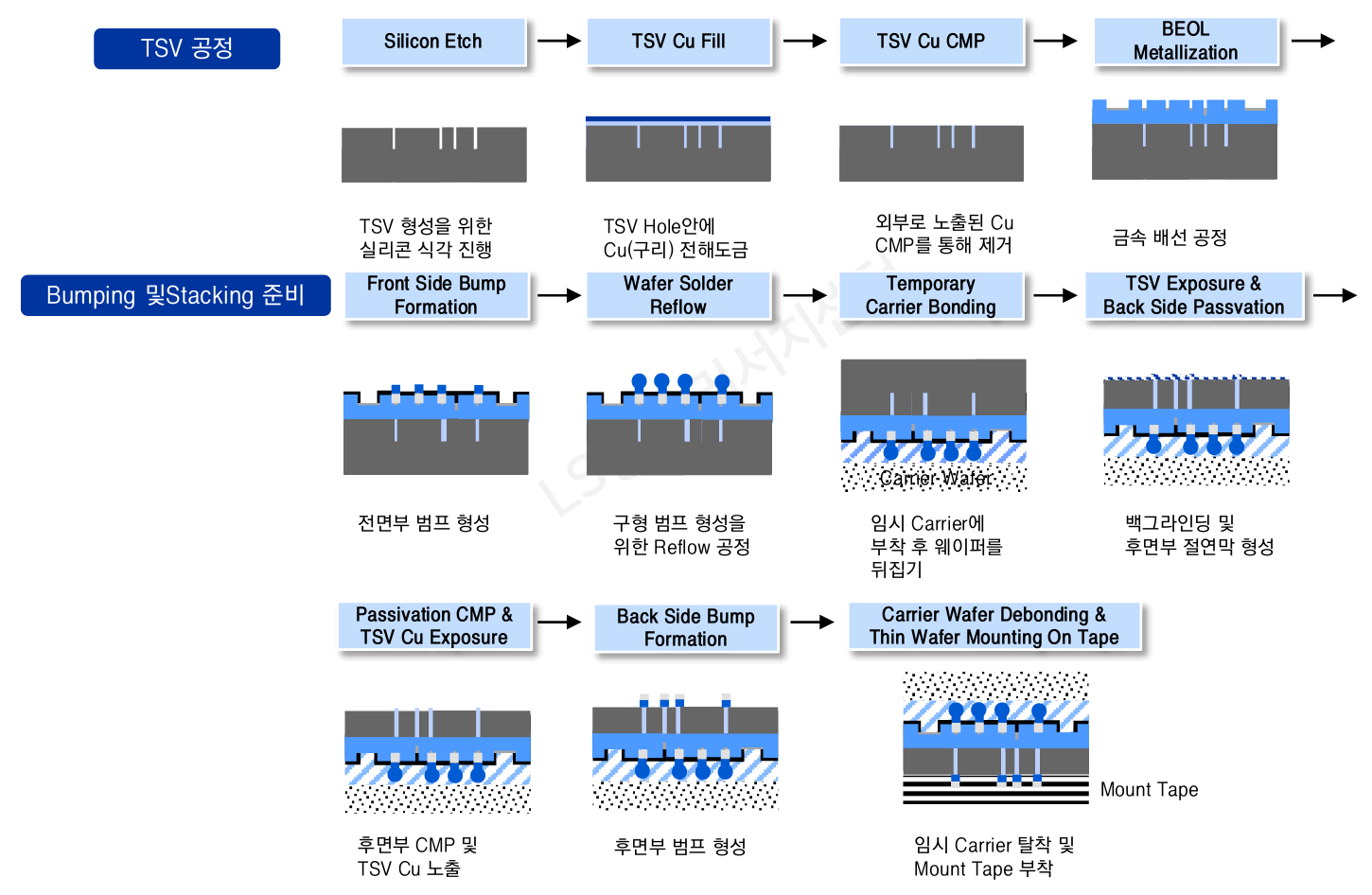
- HBM value chain (Source: LS증권)
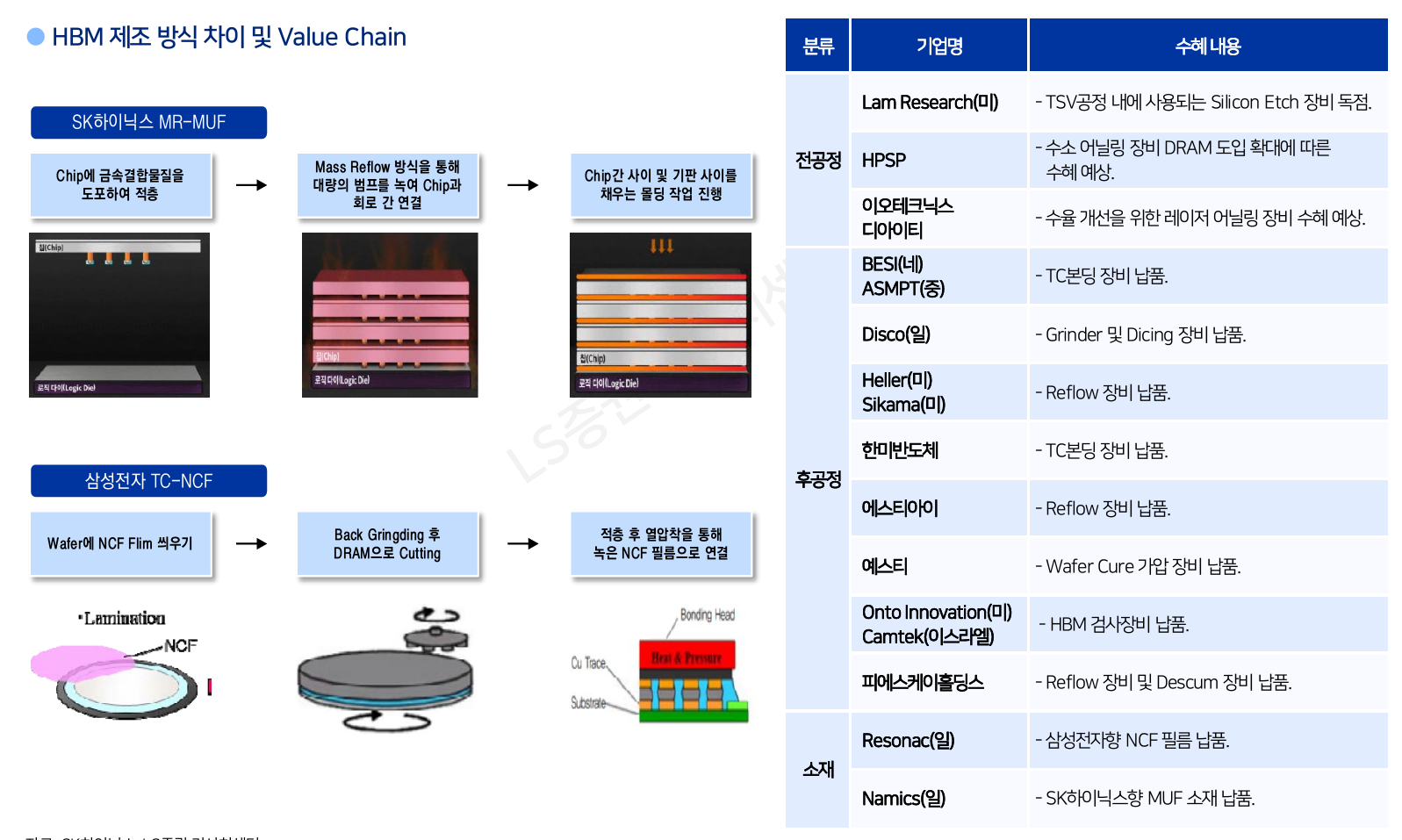
- GDDR vs. HBM/HBM structure/HBM market share (Source: LS증권)
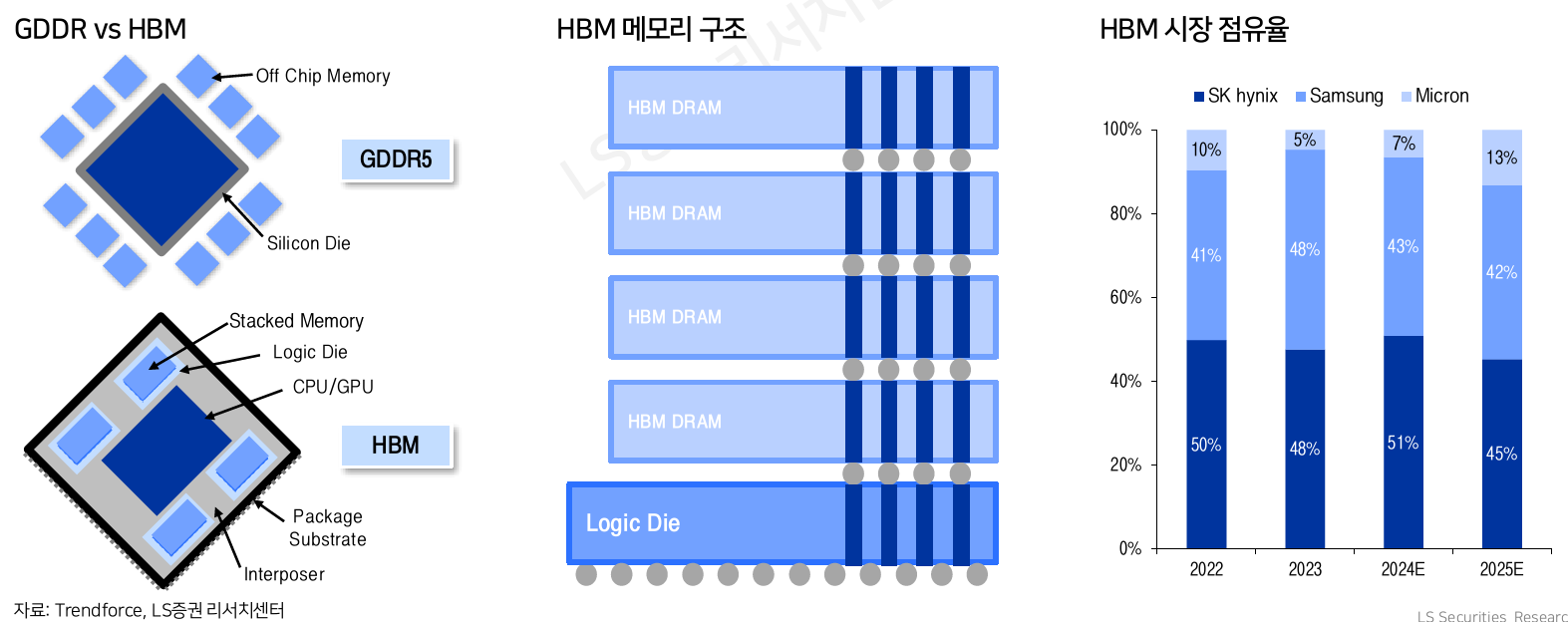
CXL (Compute Express Link)
이건 데이터 센터 단위에서 고민해야 할 문제로 보임
CXL version development (Source: LS증권)
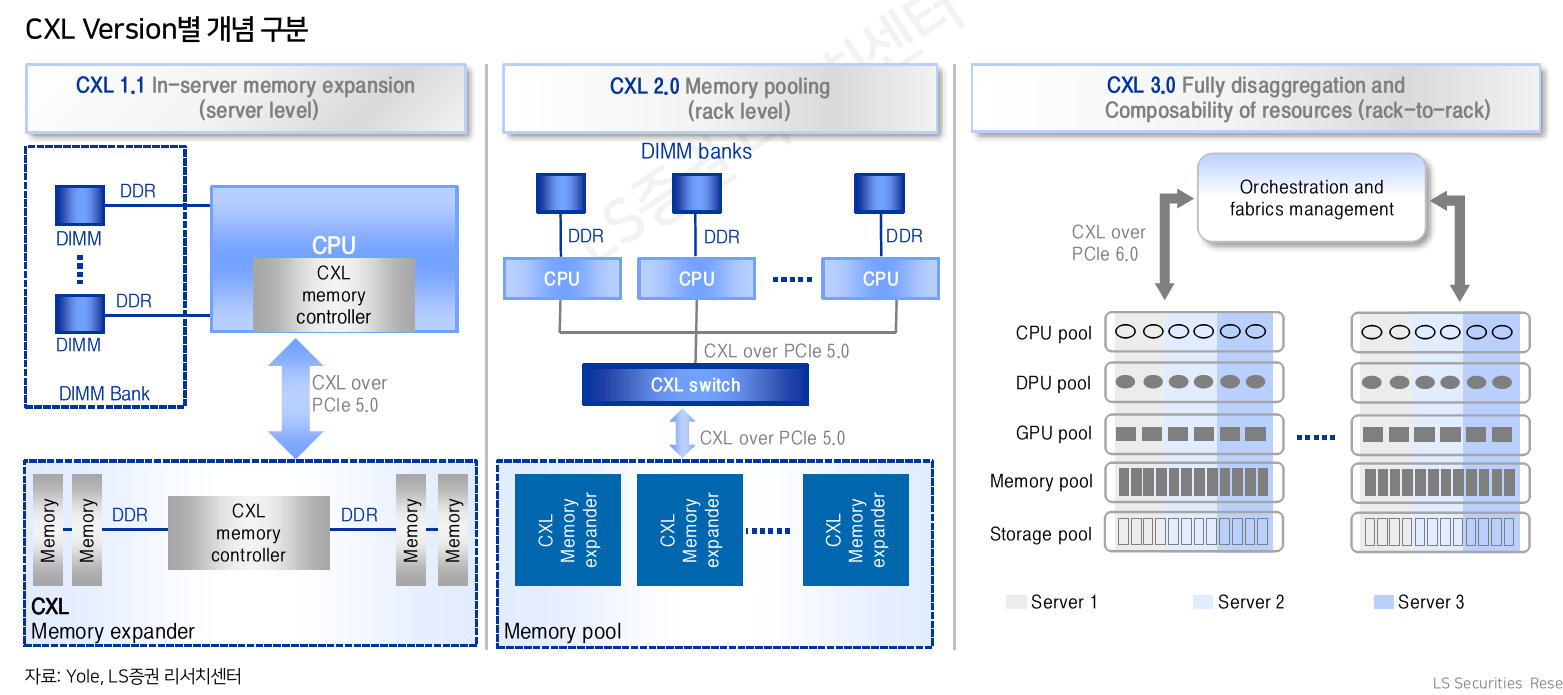
LPCAMM (Low Power Compression Attached Memory Module)/PIM (Processing in Memory)
LPCAMM
- 기존 노트북 DRAM은 탈부착이 가능한 SO-DIMM을 사용하는데, 전력 효율이 낮음
- LPDDR이 AI 칩에서 사용되고 있음
- 전력 효율이 더 좋으나 보드에 납땜이 되서 나옴
- 근데 온보드로 나오면 당연히 탈부착보다 좋아야지… 하는 생각이 드는데
- 뭐… 애플마냥 편의성은 버리고 램으로 가격장사하는 방식도 가능…
- LPCAMM은 SO-DIMM과 LPDDR의 장점만 갖춘 형식
PIM
메모리 내에서 일부 간단한 연산을 하도록 구현
Memory → CPU → GPU/Memory로 이어지는 CPU의 연산 독점을 해소하고자 하는 방안인듯
병목도 줄이고 전력 효율도 높이고
LPCAMM/PIM structure (Source: LS증권)

On Device AI
- Training/Inference chip/AI edge device market share estimates (Source: LS증권)
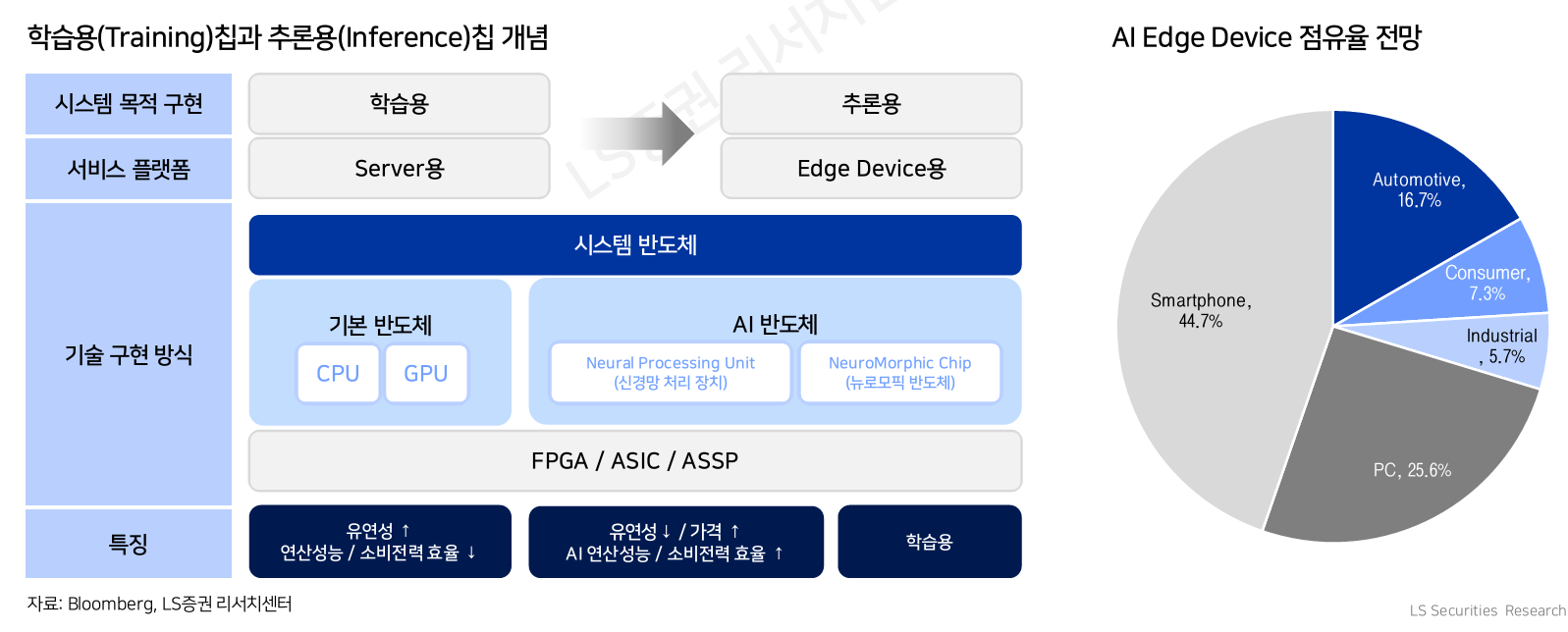
Glass substrate
유리 기판
미세 선폭 구현
대면적 수율 향상
전력 무결성
Glass substrate comparison (Source: LS증권)
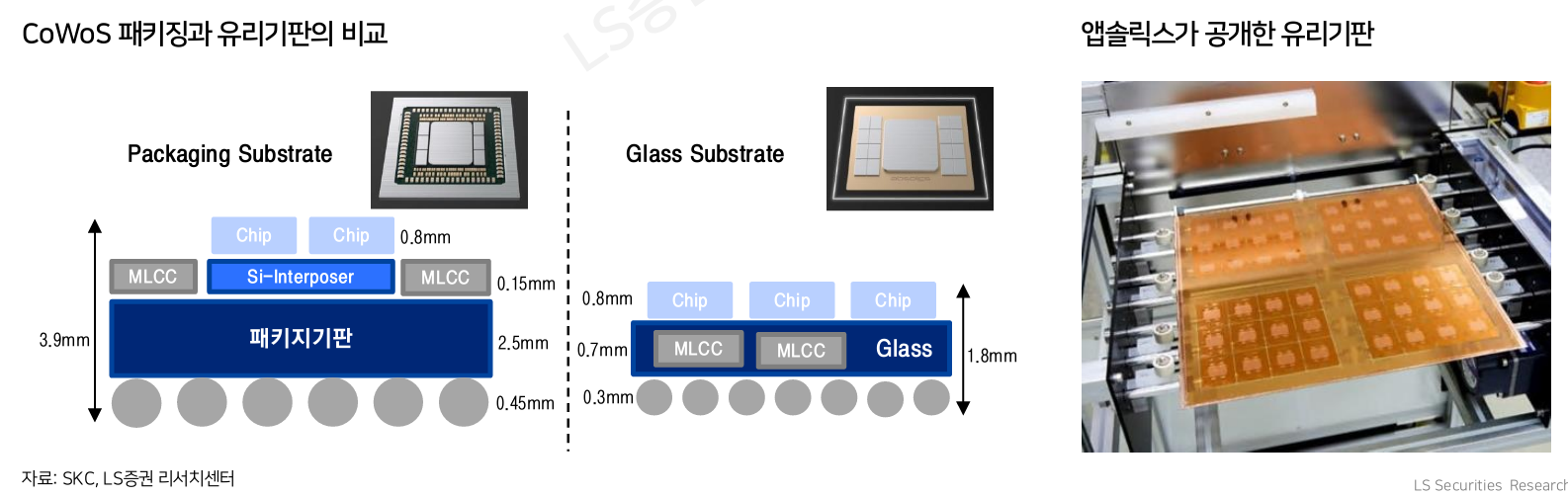
Semiconductor market
- Global market share by semiconductor value chain (Source: LS증권)


- Front-end process domestic value chain (Source: LS증권)

- Back-end process domestic value chain (Source: LS증권)

References
- 반도체 톺아보기 (2024-11-06, LS증권)
Disclaimer!
- 본 게시물은 단순 의견 및 기록 목적으로 작성되었으며 특정 투자상품의 매수·매도·보유 등 투자 권유를 의미하지 않습니다
- 본 게시물은 작성자 개인의 판단에 근거하여 작성되었고, 작성자 본인이 속한 기관의 의견을 대변하지 않습니다
- 본 게시물은 작성자 본인이 작성일 시점에 신뢰할 만하다고 판단하는 자료와 정보에 근거하였으나, 정확성이나 완전성, 신뢰성을 보장하지 않습니다
- 본 게시물은 그 어떠한 경우에도 증권, 파생상품 등 금융투자상품에 대한 투자조언으로 해석될 수 없습니다
- 본 게시물은 투자자의 투자 결과에 대해 어떠한 목적의 증빙자료로도 사용될 수 없습니다
- 본 게시물을 이용함으로써 발생하는 직·간접적 손실에 대해 어떠한 책임도 지지 않습니다